
6月8日至6月12日,超大规模集成电路研讨会(Symposium on VLSI Technology and Circuits,简称VLSI)在日本京都举办。bevictor伟德官网1篇研究论文入选VLSI技术组,报道了氧化物半导体器件可靠性的最新研究进展。该工作以“First Direct Observation of Two Different Hydrogen-Related Processes Corresponding to the Negative VTH Shift under PBTI Stress in IGZO Transistors by Pd Hydrogen Spillover”为题在VLSI 2025上发表并作会议报告。公司博士生林志予与华为海思团队康璐博士为共同第一作者,公司司梦维副教授与华为海思团队吴颖博士为共同通讯作者。

林志予在VLSI 2025现场汇报
IGZO晶体管因其可自底向上加工、高迁移率和低漏电等特性,在DRAM存储器及单片三维集成中具有很好的应用前景。然而,偏压温度稳定性问题一直是制约其发展的关键瓶颈。其中主要难点在于如何澄清氢元素相关缺陷对偏压温度稳定性影响。先前研究虽推测氢可能是导致VTH负漂的原因,但缺乏直接证据,且氢的具体作用机制尚不明确。针对上述技术难点,研究团队创新性地提出了一种通过Pd电极氢溢出的方法,首次实现了对氢在IGZO沟道中行为的直接调节。Pd作为氢催化剂,能够吸收并解离氢气形成氢原子,从而调控IGZO沟道中氢的浓度和分布,如图2(a)所示。通过氢环境原位测试IGZO晶体管可靠性,成功区分了两种氢相关的VTH负漂机制。其中,快氢机制发生在毫秒至秒的时间尺度上,表现为可恢复的VTH负漂,具有更小的时间常数、更小的电压加速因子、更小的活化能;慢氢机制发生在10秒及以上时间尺度上,表现为不可恢复的VTH负漂,具有更大的时间常数、更大的电压加速因子、更大的活化能,如图2(b)所示。通过优化工艺来抑制氢相关缺陷产生,团队实现了在6 MV/cm电场和150°C高温下1 ks应力时间内仅18.4 mV的阈值电压偏移,在当前氧化物半导体晶体管正偏压温度稳定性的研究中达到了较高的水平,如图2(c)所示。
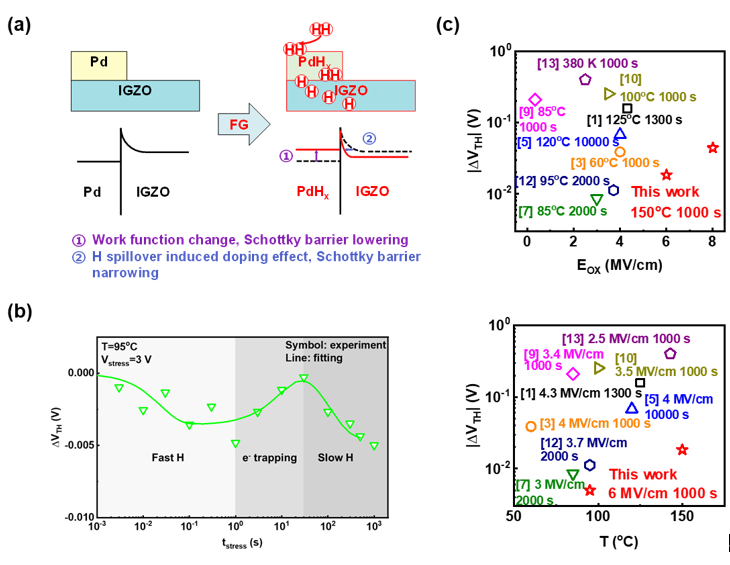
图2(a)Pd电极氢溢出原理;(b)正偏压温度稳定性中的两种氢相关机制;(c)正偏压温度稳定性性能对比
VLSI是集成电路领域的顶级会议,在国际半导体技术界享有很高的学术地位和广泛的影响力,是产业界和学术界展现集成电路领域最新研究进展和成果的重要平台。每年Intel、Samsung、TSMC、SK hynix等知名半导体公司都在会上发布最新研究进展。本次研讨会的主题是“Cultivating the VLSI Garden: From Seeds of Innovation to Thriving Growth”(深耕VLSI沃土:从创新萌芽到繁荣发展)。会议链接:https://www.vlsisymposium.org/。